测量原理
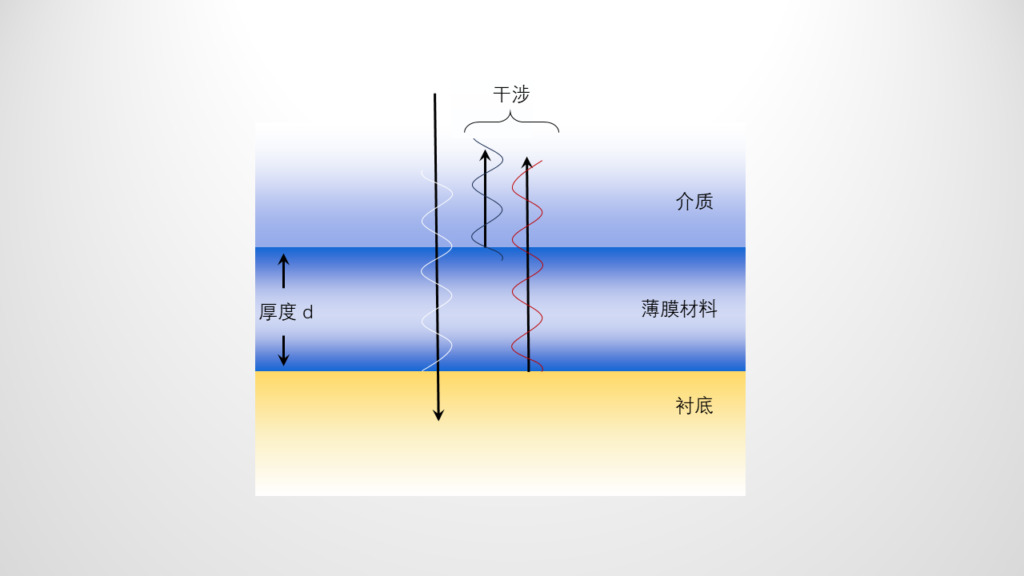
垂直入射的高稳定宽波段光入射到样品表面,在各膜层之间产生光学干涉现象,反射光经过光谱分析以及回归算法可计算出薄膜各层的厚度。适合测量纳米级至微米级的透明或半透明膜层的厚度、反射率、折射率等参数。

硅片上SiO2膜的干涉反射率曲线

产品特色
软硬件完全国产化
测量范围:可测量1纳米到250微米的薄膜厚度、折射率、反射率。
非接触测量:可测量硬质材料、软质材料或表面易受损的样品。
高精度,高稳定性:亚纳米级厚度测量精度,静态稳定性可达0.02纳米。
多层膜测量能力:可以测量多层复合薄膜各层的厚度。
智能化算法:核心专利算法,一键式测量大跨度膜厚,极大简化测量流程。
独特的软件功能:自研PolarX分析软件,包含配方预测验证、特殊材料捏合等独特功能。
核心功能

薄膜测量:反射率最优化拟合算法
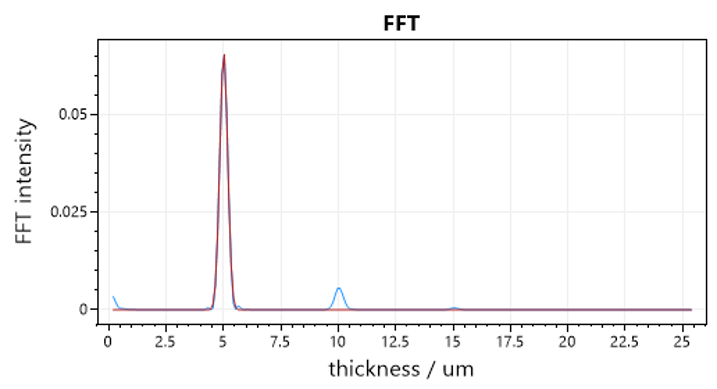
厚膜测量:傅里叶变换算法

配方预测验证算法
(一键式测量多种厚度的样品)
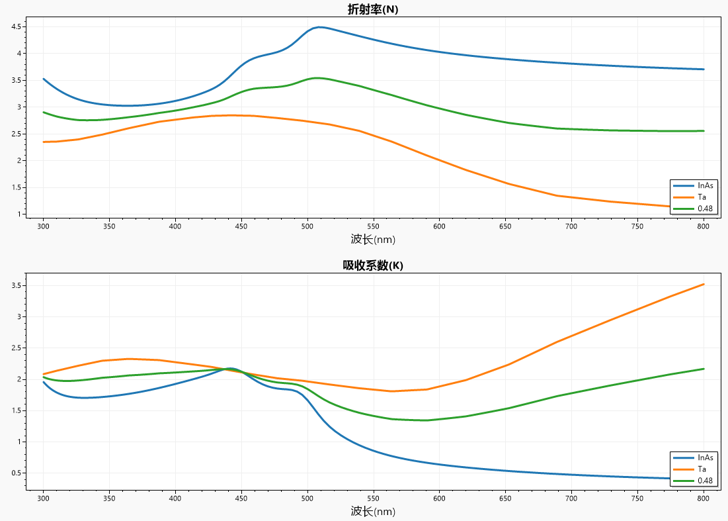
特殊材料捏合可视化

 中文
中文 English
English

